Статические характеристики
На рис. 11 показаны выходные характеристики MOSFET, имеющего внутренний инверсный диод, и переходная характеристика диода.

Рис. 11.
а) Выходные характеристики n-канального MOSFET;
б) переходная характеристика ID = f(VGS)
К стационарным режимам коммутации относятся прямое выключенное состояние и лавинный пробой. Если к транзистору приложено положительное напряжение «сток–исток» VDS, а сигнал «затвор–исток» VGS находится ниже порогового уровня VGS(th), то транзистор проводит только очень малый ток утечки IDSS. С увеличением VDS ток IDSS сначала немного возрастает. Когда напряжение «сток–исток» превышает предельно допустимый уровень VDSS, происходит лавинный пробой в PIN-переходе: p+-карман/n—-дрейфовая зона/n+-эпитаксиальный слой. По физике процесса величина V(BR)DSS примерно соответствует напряжению пробоя VCER паразитного биполярного n-p-n-транзистора, образованного следующими слоями MOSFET-структуры: n+-область истока (эмиттер)/p+-карман (база)/n—-дрейфовая зона/n+-эпитаксиальный слой в области стока (коллектор).
Ток, генерируемый при лавинном пробое в «коллектор-базовом» диоде, может привести к открыванию биполярного транзистора и разрушению MOSFET-структуры. Области базы и эмиттера почти закорочены металлизацией эмиттера, между ними нет ничего, кроме бокового сопротивления р+-кармана. С помощью различных технологических мер, к которым относятся уменьшение размера ячеек, равномерное распределение поля в ячейках, снижение сопротивления р+-карманов, а также оптимизация внешней структуры, удается добиться очень низкого тока пробоя в ячейках, что позволяет (при определенных условиях) исключить защелкивание паразитной биполярной структуры. Для таких кристаллов MOSFET, имеющих повышенную стойкость к пробою, в документации определяется допустимый уровень лавинной энергии ЕА, нормируемый для одиночного импульса или периодической нагрузки (в этом случае он ограничен предельной температурой кристалла).
Гарантировать абсолютно симметричное распределение токов параллельных чипов, входящих в состав силового ключа, невозможно, поэтому норма ЕА, определяемая для одного кристалла, относится ко всему модулю.
Ток в открытом состоянии
Величина, определяемая в спецификации как максимальный ток коллектора IGBT IC или стока MOSFET ID, при котором достигается предельный нагрев кристаллов Tj(max) при температуре корпуса Tc= +25 и +80 °C (для базовых модулей) или +25 и +70 °C (для безбазовых модулей), рассчитывается следующим образом:
IC = (Tj(max)–Tc)/(VCE(sat) × Rth(j-c));
ID = √(Tj(max)–Tc)/(RDS(on) × Rth(j-c)).
Для силовых ключей без базовой платы вместо параметров Tcи Rth(j-c) используются Ts (температура радиатора) и Rth(j-s) (тепловое сопротивление «кристалл – радиатор»); RDS(on) и VCE(sat) в приведенных выражениях должны соответствовать максимальной температуре кристалла. Отметим, что значения IC и ID могут использоваться только для грубой оценки или сравнения, поскольку реальные величины рабочих токов зависят от конкретных условий эксплуатации и должны определяться с помощью теплового расчета.
Величина IСnom (равная номинальному току кристалла, умноженному на количество параллельных чипов) также необходима для предварительной оценки, поскольку, как и в предыдущем случае, она определяется для DC-режима.
Значение повторяющегося пикового тока коллектора IСRM является предельным для состояния периодической длительной коммутации, оно не зависит от температуры и ограничено допустимой плотностью тока кристалла. В большинстве спецификаций величина IСRM ранее определялась как двойной номинал (2IСnom). Для новейших кристаллов Trench 4 производитель указывает IСRM= 3IСnom, но без определения допустимой длительности импульса. Как показывают соответствующие тесты, повторяющееся отключение такого тока может привести к раннему выходу из насыщения наиболее нагретого кристалла и, следовательно, увеличению потерь мощности. Поэтому SEMIKRON рекомендует выходить за определенные ранее пределы области безопасной работы RBSOA (2IСnom) только в исключительных случаях, например при пониженном напряжении DC-шины или плавном отключении (Soft Turn Off).
Еще одним лимитирующим фактором является максимальный эффективный ток модуля It(RMS), усредненный за период рабочей частоты. Это ограничение применимо к любой токовой характеристике, углу отсечки, условиям охлаждения. Величина It(RMS) определяется нагрузочной способностью внутренних шин и внешних терминалов силового ключа.
Характеристики оппозитных/антипараллельных диодов IGBT, такие как прямой ток IF, ток чипа IFnom и пиковый прямой ток IFRM, определяются так же, как и для транзисторов. Значение допустимой непериодической перегрузки IFSM выпрямительных диодов необходимо для выбора параметров соответствующих средств защиты (предохранителей, автоматов). Эта величина соответствует предельному пиковому току импульса 50 Гц полусинусоидальной формы, который диод способен выдержать без повреждения в аварийном режиме (КЗ) несколько раз в течение срока службы.
Как правило, максимальные нагрузочные характеристики силового преобразователя определяются балансом потерь мощности транзисторов и диодов (статических, динамических, восстановления) и возможностью отвода тепла, генерируемого кристаллами, через корпус модуля и радиатор в охлаждающую среду. При этом:
- Должны быть исключены статические и динамические состояния (кроме случая отключения тока КЗ в рамках ограничений области безопасной работы SCSOA), при которых перегрев кристаллов IGBT, MOSFET, диодов превышает установленные лимиты.
- Перепады температуры, обусловленные изменениями нагрузки или окружающей среды, и вызванные ими термомеханические напряжения не должны приводить к сокращению срока службы и преждевременному отказу модулей.
Кроме того, существуют ограничения, обусловленные следующими факторами:
- коммутационная способность силовых ключей в номинальном режиме и при перегрузке, вплоть до максимального тока (т. е. в пределах ОБР);
- возможности активных и пассивных средств защиты от перегрузки по току;
- величина коммутационных перенапряжений.
Дрейф порогового напряжения VGS(th)
Природа широкозонных материалов и свойства интерфейсного слоя «полупроводник-диэлектрик» SiC обуславливают особенности температурных характеристик порогового напряжения (BTI — Bias Temperature Instability). Были проведены детальные исследования, направленные на изучение данных особенностей, объяснение их связи со свойствами полупроводниковых материалов и их влияния на работу в конкретных применениях. Испытания выполнялись на макете инвертора с карбидокремниевым модулем SK200MB120TSCE2 (кристаллы Infineon CoolSiC) в корпусе SEMITOP E2 (рис. 3).
Рис. 3. Тестовый инвертор с модулем SK200MB120TSCE2 и драйвером SKYPER 12, корпус SEMITOP E2.
Для изучения статических характеристик управления SiC MOSFET необходима адаптация стандартных условий, используемых при тестировании кремниевых ключей. С этой целью разработана новая процедура оценки параметров затвора, позволяющая различать динамический обратимый гистерезис порогового напряжения VGS(th) и его медленные температурные и временные вариации .
Кроме изменений, связанных со статическими процессами, пороговое напряжение SiC MOSFET имеет дрейф, вызванный включением и выключением прибора. Этот дополнительный компонент может быть идентифицирован только в ходе долговременных импульсных тестов. Современные исследования показывают, что данный эффект связан с динамикой оксидного слоя затвора и он присущ всем существующим технологиям SiC MOSFET. С течением времени коммутация транзистора приводит к медленному увеличению VGS(th) с течением времени. Его величина одинакова у различных приборов, находящихся в одинаковых условиях эксплуатации. Независимо от выбранных параметров, отрицательный дрейф порогового напряжения никогда не наблюдался. Изменение порогового напряжения влияет на сопротивление канала RDS(on), таким образом в ходе эксплуатации статические потери увеличиваются.
Основные параметры, подверженные влиянию динамического дрейфа VGS(th):
- общее количество циклов коммутации, трансформируемое в частоту переключения и суммарное время работы;
- напряжение выключения VGS(off);
- напряжение управления на выводах «затвор-исток» чипа (может выйти за границы допустимого диапазона).
IRF3205ZPBF MOSFET — описание производителя. Даташиты. Основные параметры и характеристики. Поиск аналога. Справочник
Наименование прибора: IRF3205ZPBF
Тип транзистора: MOSFET
Полярность: N
Максимальная рассеиваемая мощность (Pd): 170
W
Предельно допустимое напряжение сток-исток |Uds|: 55
V
Предельно допустимое напряжение затвор-исток |Ugs|: 20
V
Пороговое напряжение включения |Ugs(th)|: 4
V
Максимально допустимый постоянный ток стока |Id|: 75
A
Максимальная температура канала (Tj): 175
°C
Общий заряд затвора (Qg): 110
nC
Время нарастания (tr): 95
ns
Выходная емкость (Cd): 550
pf
Сопротивление сток-исток открытого транзистора (Rds): 0.0065
Ohm
Тип корпуса:
IRF3205ZPBF
Datasheet (PDF)
0.1. irf3205zpbf irf3205zlpbf irf3205zspbf.pdf Size:379K _international_rectifier
PD — 95129AIRF3205ZPbFIRF3205ZSPbFIRF3205ZLPbFFeaturesl Advanced Process TechnologyHEXFET Power MOSFETl Ultra Low On-ResistanceDl 175C Operating TemperatureVDSS = 55Vl Fast Switchingl Repetitive Avalanche Allowed up to TjmaxRDS(on) = 6.5ml Lead-FreeGDescriptionID = 75ASThis HEXFET Power MOSFET utilizes the latestprocessing techniques to achieve e
0.2. irf3205zpbf irf3205zspbf irf3205zlpbf.pdf Size:379K _infineon
PD — 95129AIRF3205ZPbFIRF3205ZSPbFIRF3205ZLPbFFeaturesl Advanced Process TechnologyHEXFET Power MOSFETl Ultra Low On-ResistanceDl 175C Operating TemperatureVDSS = 55Vl Fast Switchingl Repetitive Avalanche Allowed up to TjmaxRDS(on) = 6.5ml Lead-FreeGDescriptionID = 75ASThis HEXFET Power MOSFET utilizes the latestprocessing techniques to achieve e
6.1. auirf3205zstrl.pdf Size:330K _international_rectifier
PD — 97542AUTOMOTIVE GRADEAUIRF3205ZAUIRF3205ZSFeatures Advanced Process TechnologyHEXFET Power MOSFET Ultra Low On-Resistance 175C Operating Temperature DV(BR)DSS55V Fast SwitchingRDS(on) max.6.5m Repetitive Avalanche Allowed up toTjmaxGID (Silicon Limited) 110A Lead-Free, RoHS CompliantS Automotive Qualified *ID (Package Li
6.2. irf3205z.pdf Size:181K _international_rectifier
PD — 94653AUTOMOTIVE MOSFETIRF3205ZHEXFET Power MOSFETFeaturesD Advanced Process TechnologyVDSS = 55V Ultra Low On-Resistance 175C Operating TemperatureRDS(on) = 6.5m Fast SwitchingG Repetitive Avalanche Allowed up to TjmaxID = 75ASDescriptionSpecifically designed for Automotive applications, this HEXFET PowerMOSFET utilizes the latest
6.3. irf3205z irf3205zs irf3205zl.pdf Size:303K _infineon
PD — 94653BIRF3205ZAUTOMOTIVE MOSFETIRF3205ZSIRF3205ZLFeaturesHEXFET Power MOSFET Advanced Process TechnologyD Ultra Low On-ResistanceVDSS = 55V 175C Operating Temperature Fast Switching Repetitive Avalanche Allowed up to TjmaxRDS(on) = 6.5mGDescriptionID = 75ASpecifically designed for Automotive applications,Sthis HEXFET Power MOS
6.4. auirf3205z auirf3205zs.pdf Size:707K _infineon
AUIRF3205Z AUTOMOTIVE GRADE AUIRF3205ZS HEXFET Power MOSFET Features VDSS 55V Advanced Process Technology Ultra Low On-Resistance RDS(on) max. 6.5m 175C Operating Temperature ID (Silicon Limited) 110A Fast Switching Repetitive Avalanche Allowed up to Tjmax ID (Package Limited) 75A Lead-Free, RoHS Compliant Automotive Qualified *
6.5. irf3205zs.pdf Size:258K _inchange_semiconductor
Isc N-Channel MOSFET Transistor IRF3205ZSFEATURESWith To-263(D2PAK) packageLow input capacitance and gate chargeLow gate input resistance100% avalanche testedMinimum Lot-to-Lot variations for robust deviceperformance and reliable operationAPPLICATIONSSwitching applicationsABSOLUTE MAXIMUM RATINGS(T =25)aSYMBOL PARAMETER VALUE UNITV Drain-Source Vol
6.6. irf3205z.pdf Size:246K _inchange_semiconductor
INCHANGE Semiconductorisc N-Channel MOSFET Transistor IRF3205ZIIRF3205ZFEATURESStatic drain-source on-resistance:RDS(on) 6.5mEnhancement modeFast Switching Speed100% avalanche testedMinimum Lot-to-Lot variations for robust deviceperformance and reliable operationDESCRITIONreliable device for use in a wide variety of applicationsABSOLUTE MAXIMUM
Другие MOSFET… SMG2301
, SMG2301P
, SMG2302
, SMG2302N
, SMG2305
, SMG2305P
, SMG2305PE
, SMG2306A
, IRF1404
, SMG2306NE
, SMG2310A
, SMG2310N
, SMG2314N
, SMG2314NE
, SMG2318N
, SMG2319P
, SMG2321P
.
Особенности режима усиления
Увеличение положительного напряжения затвора вызовет появление сопротивления в канале. Это не покажет тестер транзисторов, он может только проверить целостность переходов. Чтобы уменьшить дальнейший рост, нужно увеличить тока стока. Другими словами, для режима усиления п-канального МОП-транзистора:
- Положительный сигнал транзистор переводит в проводящий режим.
- Отсутствие сигнала или же его отрицательное значение переводит в непроводящий режим транзистор. Следовательно, в режиме усиления МОП-транзистор эквивалентен «нормально разомкнутому» переключателю.
Обратные утверждения справедливы для режимов усиления р-канальных МОП-транзисторов. При нулевом напряжении устройство в режиме «Выкл» и канал открыт. Применение напряжения отрицательного значения к затвору р-типа у MOSFET увеличивает проводимость каналов, переводя его режим «Вкл». Проверить можно, используя тестер (цифровой или стрелочный). Тогда для режима усиления р-канального МОП-транзистора:
- Положительный сигнал переводит транзистор «Выкл».
- Отрицательный включает транзистор в режим «Вкл».
Управление SiC, общие положения
В общем случае оптимальные токовые характеристики карбидокремниевых ключей обеспечиваются при напряжении на затворе VGS = 18…20 В, что подтверждается кривыми, показанными на рис. 1 и 2. Как видно из рисунков, у карбида кремния намного выше модулирующий эффект напряжения управления. Это справедливо для режимов, где SiC-прибор ведет себя, как управляемое напряжением сопротивление или как управляемый напряжением источник тока, зависящий от VDS.

Рис. 1. Типовая выходная характеристика SiC MOSFET при температуре кристалла Tj = +25° (а) и = 125°C (б)

Рис. 2. Типовая передаточная характеристика SiC MOSFET при температуре кристалла Tj = +25 и +125°С
В открытом состоянии напряжение «сток-исток» VDS SiC MOSFET, как правило, больше, чем VCE(sat) Si MOSFET и IGBT. Данный факт влияет на работу схем контроля выхода из насыщения, особенно если учесть свойство перехода транзисторов в режим стабилизации тока при перегрузке.
Типичной ошибкой является выбор устройства управления по напряжению на затворе без учета выходного сопротивления и нагрузочной способности прибора. Очевидно, что кроме соответствующих значений VGS_on и VGS_off драйвер должен иметь высокий пиковый ток, низкое выходное сопротивление и мощность, достаточную для управления затвором на заданной частоте коммутации.
Перепад напряжения управления ΔVGS SiC-ключей — не менее 22 В, при этом рекомендуемые значения VGS_on (+20 В) и VGS_off (от -2 до -5 В) отличаются от величин, традиционно используемых для контроля кремниевых MOSFET и IGBT. Также отметим, что суммарный заряд затвора (Qg_tot) у SiC MOSFET значительно меньше, соответственно, меньше и энергия управления или произведение ΔVGS на заряд Qg. Однако это трудно назвать преимуществом SiC MOSFET, которые предназначены для работы на повышенных частотах. Импульсы на затворе должны иметь малое время нарастания и спада, что требует низкого импеданса драйвера и минимальной индуктивности его соединения с затвором.
Типовое пороговое напряжение включения SiC MOSFET составляет 2,5 В, но карбидокремниевый ключ не может открыться полностью до тех пор, пока VGS не достигнет 18…20 В. Таким образом диапазон изменения напряжения на затворе SiC заметно шире, чем у кремниевых транзисторов MOSFET и IGBT. Высокий «модулирующий эффект» считается одним из недостатков карбида кремния. Следствие этого — меньшая стойкость SiC-модулей к шумовым сигналам. Любой «звон», возникающий на управляющем выводе, может привести к ложному включению или частичному выключению устройства.
Одно из основных преимуществ SiC MOSFET – отсутствие «хвостового» тока, присущего IGBT-модулям. Тем не менее, этот паразитный эффект биполярных структур обеспечивает определенную степень демпфирования переходных процессов. При замене кремниевых ключей на карбидокремниевые усиливаются переходные процессы, а уровень коммутационных перенапряжений может оказаться достаточным для пробоя полупроводникового прибора. Для решения этих проблем следует оптимизировать схему управления, минимизировать паразитные индуктивности в цепи коммутации и в ряде случаев использовать дополнительные снабберные цепи.
Полевые транзисторы с управляющим p-n переходом
Схематически полевой транзистор с управляющим p-n переходом можно представить в виде пластины, к торцам которой подключены электроды, исток и сток. На рис. показана структура и схема включения полевого транзистора с каналом n-типа:
В транзисторе с n-каналом основными носителями заряда в канале являются электроны, которые движутся вдоль канала от истока с низким потенциалом к стоку с более высоким потенциалом, образуя ток стока Ic. Между затвором и истоком приложено напряжение, запирающее p-n переход, образованный n-областью канала и p-областью затвора.
При подаче запирающего напряжения на p-n-переход Uзи на границах канала возникает равномерный слой, обедненный носителями заряда и обладающий высоким удельным сопротивлением. Это приводит к уменьшению проводящей ширины канала.
Изменяя величину этого напряжения, можно изменить сечение канала и, следовательно, изменять величину электрического сопротивления канала. Для полевого n-канального транзистора потенциал стока положителен по отношению к потенциалу истока. При заземленном затворе от стока к истоку протекает ток. Поэтому для прекращения тока на затвор нужно подать обратное напряжение в несколько вольт.
Значение напряжения Uзи, при котором ток через канал становится практически равен нулю, называется напряжением отсечки Uзап
Таким образом, полевой транзистор с затвором в виде p-n-перехода представляет собой сопротивление, величина которого регулируется внешним напряжением.
Полевой транзистор характеризуется следующей ВАХ:
Здесь зависимости тока стока Iс от напряжения при постоянном напряжении на затворе Uзи определяют выходные, или стоковые, характеристики полевого транзистора. На начальном участке характеристик Uси + |Uзи| < Uзап ток стока Iс возрастает с увеличением Uси. При повышении напряжения сток — исток до Uси = Uзап — |Uзи| происходит перекрытие канала и дальнейший рост тока Iс прекращается (участок насыщения). Отрицательное напряжение Uзи между затвором и истоком смещает момент перекрытия канала в сторону меньших значений напряжения Uси и тока стока Iс. Участок насыщения является рабочей областью выходных характеристик полевого транзистора. Дальнейшее увеличение напряжения Uси приводит к пробою р-n-перехода между затвором и каналом и выводит транзистор из строя.
На ВАХ Iс = f(Uзи) показано напряжение Uзап. Так как Uзи ≤ 0 p-n-переход закрыт и ток затвора очень мал, порядка 10-8…10-9 А, поэтому к основным преимуществам полевого транзистора, по сравнению с биполярным, относится высокое входное сопротивление, порядка 1010…1013 Ом. Кроме того, они отличаются малыми шумами и технологичностью изготовления.
Практическое применение имеют две основные схемы включения. Схема с общим истоком (рис. а) и схема с общим стоком (рис. б) , которые показаны на рисунке:
Базовая структура MOSFET транзистора
Конструкция MOSFET (что это, рассказано в статье подробно) очень отличается от полевых. Оба типа транзисторов используют электрическое поле, создаваемое напряжением на затворе. Чтобы изменить поток носителей заряда, электронов для п-канала или отверстия для р-канала, через полупроводящий канал сток-исток. Электрод затвора помещен на вершине очень тонким изолирующим слоем, и есть пара небольших областей п-типа только под сток и исток электродов.
При помощи изолированного устройства затвора для МОП-транзистора никаких ограничений не применяется. Поэтому можно соединять с затвором полевого МОП-транзистора источник сигнала в любой полярности (положительный или отрицательной). Стоит отметить, что чаще встречаются импортные транзисторы, нежели их отечественные аналоги.
Это делает MOSFET устройства особенно ценными в качестве электронных переключателей или логических приборов, потому что без воздействия извне они, как правило, не проводят ток. И причина этому высокое входное сопротивление затвора. Следовательно, очень маленький или несущественный контроль необходим для МОП-транзисторов. Ведь они представляют собой устройства, управляемые извне напряжением.
Строение полевого транзистора
Давайте еще раз рассмотрим структуру полевого транзистора.
Имеем “кирпич” полупроводникового материала P-проводимости. Как вы помните, основными носителями в полупроводнике P-типа являются дырки, поэтому, их концентрация намного больше, чем электронов. Но электроны также есть и в P-полупроводнике. Как вы помните, электроны в P-полупроводнике – это неосновные носители и их концентрация очень мала, по сравнению с дырками. “Кирпич” P-полупроводника носит название Подложки. От подложки выходит вывод с таким же названием: подложка.
Другие слои – это материал N+ типа, диэлектрик, металл. Почему N+, а не просто N? Дело в том, что этот материал сильно легирован, то есть концентрация электронов в этом полупроводнике очень большая. От полупроводников N+ типа, которые располагаются по краям, отходят два вывода: Исток и Сток.
Между Истоком и Стоком через диэлектрик располагается металлическая пластинка, от который идет вывод. Называется этот вывод Затвором. Между Затвором и другими выводами нет никакой электрической связи. Затвор вообще изолирован от всех выводов транзистора, поэтому МОП-транзистор также называют транзистором с изолированным затвором.
Мы видим, что полевой транзистор на схеме имеет 4 вывода (Исток, Сток, Затвор и Подложка), а реальный транзистор имеет только 3 вывода.
В чем прикол? Дело все в том, что Подложку обычно соединяют с Истоком. Иногда это уже делается в самом транзисторе еще на этапе разработки. В результате того, что Исток соединен с Подложкой, у нас образуется диод между Стоком и Истоком, который иногда даже не указывается в схемах, но всегда присутствует:
Поэтому, следует соблюдать цоколевку при подключении МОП-транзистора в схему.
Строительство N-канального МОП-транзистора
Давайте рассмотрим N-канальный MOSFET, чтобы понять его работу. Подложена слегка легированная подложка P-типа, в которую рассеиваются две сильно легированные области N-типа, которые действуют как исток и сток. Между этими двумя областями N + происходит диффузия с образованием N-канала, соединяющего сток и исток.
Тонкий слой диоксида кремния (SiO 2 )
выращивается по всей поверхности, и сделаны отверстия, чтобы нарисовать омические контакты для выводов стока и истока. Проводящий слойалюминия проложен по всему каналу, на этот слойSiO 2 от истока до стока, который составляет затвор.Подложка SiO 2 соединена с общей или заземленной клеммой.
Из-за своей конструкции МОП-транзистор имеет гораздо меньшую площадь микросхемы, чем BJT, что составляет 5% занятости по сравнению с биполярным переходным транзистором. Это устройство может работать в режимах. Это режимы истощения и улучшения. Давайте попробуем разобраться в деталях.
Схема измерения тока нагрузки с виртуальной землей
Схема с виртуальной землей дает наилучшие результаты относительно точности измерения и подавления шумов во всем диапазоне рабочих температур силового ключа. Типовая схема измерения тока с виртуальной землей представлена на рис. 2.
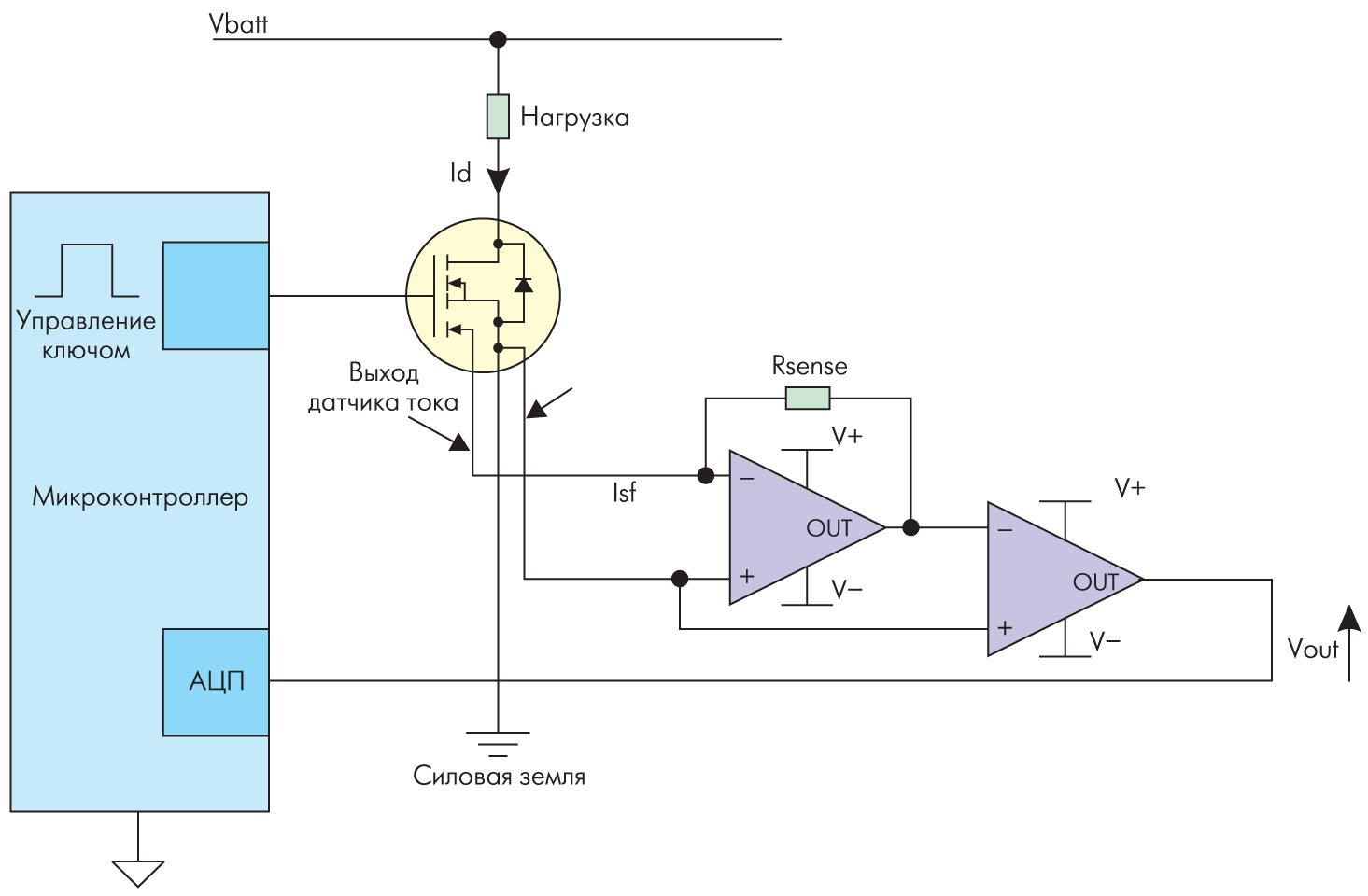
Рис. 2. Схема измерения тока нагрузки мощного MOSFET-транзистора с виртуальной землей
ОУ включен в схеме с токовой обратной связью, что обеспечивает равенство потенциалов отвода Кельвина и выхода датчика тока. Таким образом, выполняется условие, при котором отношение токов основного силового транзистора и датчика тока остается постоянным и равным заданному производителем sense ratio. Выходное напряжение схемы измерения тока составляет:
(1)
Типичная временная диаграмма напряжения на выходе схемы измерения тока нагрузки приведена на рис. 3. Из диаграммы видно, что форма напряжения полностью повторяет форму тока стока ключа во всем временном интервале.

Рис. 3. Временные диаграммы тока стока ключа и напряжения на выходе схемы измерения тока с виртуальной нагрузкой
Сравнение между BJT, FET и MOSFET
Теперь, когда мы обсудили все вышеперечисленные три, давайте попробуем сравнить некоторые их свойства.
| ТЕРМИНЫ | BJT | FET | МОП-транзистор |
| Тип устройства | Текущий контроль | Напряжение контролируется | Напряжение контролируемое |
| Текущий поток | биполярный | униполярный | униполярный |
| терминалы | Не взаимозаменяемы | взаимозаменяемый | взаимозаменяемый |
| Режимы работы | Нет режимов | Только режим истощения | Оба режима повышения и истощения |
| Входное сопротивление | Низкий | Высоко | Очень высоко |
| Выходное сопротивление | умеренный | умеренный | Низкий |
| Рабочая скорость | Низкий | умеренный | Высоко |
| Шум | Высоко | Низкий | Низкий |
| Термостойкость | Низкий | Лучше | Высоко |
До сих пор мы обсуждали различные электронные компоненты и их типы, а также их конструкцию и работу. Все эти компоненты имеют различные применения в области электроники. Чтобы получить практические знания о том, как эти компоненты используются в практических схемах, обратитесь к руководству по электронным схемам.
Резюме полевых полетов против полевого МОП-транзистора
JFET и MOSFET являются двумя наиболее популярными полевыми транзисторами, обычно используемыми в электронных схемах. Как JFET, так и MOSFET являются полупроводниковыми устройствами, управляемыми напряжением, используемыми для усиления слабых сигналов с использованием эффекта электрического поля. Само название указывает на атрибуты устройства. Хотя они имеют общие атрибуты, соответствующие усилению и переключению, они имеют свою долю различий. JFET работает только в режиме истощения, тогда как MOSFET работает как в режиме истощения, так и в режиме улучшения. МОП-транзисторы используются в схемах СБИС из-за их дорогостоящего производственного процесса против менее дорогих JFET, которые в основном используются в приложениях с малым сигналом.
Что такое сток, исток и затвор
Полевой транзистор имеет три вывода. Вывод, с которого начинают свой путь электроны (основные носители) называется ИСТОКОМ. От слова “источник”. В разговорной речи мы источником называем родник, из которого бьет чистая вода. Поэтому нетрудно будет запомнить, что ИСТОК – это тот вывод, откуда начинают свой путь основные носители заряда. В данном случае это электроны. Место, куда они стекаются, называются СТОКОМ.
Эти два понятия нетрудно будет запомнить, если вспомнить водосточную систему с крыш ваших домов.
Истоком будет труба, которая собирает всю капли дождя с шифера или профнастила
А стоком будет конец трубы, из которой вся дождевая вода будет выбегать на землю:
Но опять же, не забывайте, что мы говорим об электронах! А электроны бегут к плюсу. То есть по-нашенски получается что на СТОК мы подаем плюс, а на ИСТОК – минус.
А для чего нужен третий вывод?
Так, а давайте по приколу где-нибудь обрежем нашу водосточную трубу и воткнем туда вот такой прибамбас:
Называется он дисковым затвором. Чего бы мы добились, если бы воткнули этот дисковый затвор в нашу водосточную трубу? Да покрутив за баранку, мы могли бы регулировать поток воды! Мы можем вообще полностью перекрыть трубу, тогда в этом случае на стоке не стоит ждать дождевую водичку. А можем открыть наполовину, и регулировать поток воды со стока, чтобы при ливне у нас поток воды не смыл грядки и не сделал большую яму в земле. Удобно? Удобно.
Так вот, третий вывод полевого транзистора, который соединяется с P полупроводником называется тоже ЗАТВОРОМ и служит как раз для того, чтобы регулировать силу тока в бруске, через который бежит электрический ток 😉 Для этого достаточно подать на него напряжение, чтобы P-N переход был включен в обратном направлении, то есть в нашем случае подать МИНУС относительно ИСТОКА. Вся картина в целом будет выглядеть как-то вот так:
Назначение мосфета в мехмоде
А теперь о том, зачем эту штуку устанавливают в мехмоды. В первую очередь, для безопасности. Если случится перегрузка или короткое замыкание, он прервет подачу напряжения, тем самым предотвратив беду &ndash, возгорание или тот самый пресловутый взрыв. Иногда в мехмодах с аналогичными целями устанавливаются защитные фьюзы.
 Кроме того, он обеспечивает уменьшение потерь напряжения, то есть, фактически, увеличивает его и регулирует. Если без мосфета можно пользоваться намоткой спирали атомайзера с сопротивлением не более 2 Ом, то с ним можно без опаски применять и больше. Это позволяет получить много качественного, густого, насыщенного пара. Это еще одна важная причина, по которой многие вейперы предпочитают использовать моды с мосфетом. Поступление напряжения на атомайзер, а значит, и парообразование, происходит сразу же после замыкания цепи, без задержек.
Кроме того, он обеспечивает уменьшение потерь напряжения, то есть, фактически, увеличивает его и регулирует. Если без мосфета можно пользоваться намоткой спирали атомайзера с сопротивлением не более 2 Ом, то с ним можно без опаски применять и больше. Это позволяет получить много качественного, густого, насыщенного пара. Это еще одна важная причина, по которой многие вейперы предпочитают использовать моды с мосфетом. Поступление напряжения на атомайзер, а значит, и парообразование, происходит сразу же после замыкания цепи, без задержек.
Еще одна полезная функция, которую в состоянии обеспечить моп-транзистор при использовании в механическом моде, это продление срока жизни кнопок и контактов. Без него они рано или поздно выгорают, кнопка также сильно нагревается, что делает использование устройства некомфортным. Мосфет не дает им перегреваться и выгорать, а значит &ndash, продлевает срок бесперебойной работы всего мода.
История
МОП — транзистор был изобретен Mohamed Atalla и Давоном Кангом в Bell Labs в 1959 году был прорыв в области силовой электроники . Поколения полевых МОП-транзисторов позволили разработчикам питания достичь уровней производительности и плотности, недоступных для биполярных транзисторов.
В 1969 году Hitachi представила первую вертикальную мощность MOSFET, который позже будет известен как VMOS (V-образный паз МОП — транзистор). В том же году о (полевой МОП-транзистор с двойным рассеиванием) с самовыравнивающимся затвором впервые сообщили Ю. Таруи, Ю. Хаяси и Тосихиро Секигава из Электротехнической лаборатории (ETL). В 1974 году Дзюн-ичи Нисидзава из Университета Тохоку изобрел силовой полевой МОП-транзистор для аудио, который вскоре был произведен корпорацией Yamaha Corporation для своих высококачественных аудиоусилителей . JVC , Pioneer Corporation , Sony и Toshiba также начали производство усилителей с силовыми МОП-транзисторами в 1974 году. Siliconix коммерчески представила VMOS в 1975 году.
VMOS и DMOS превратились в то, что стало известно как VDMOS (вертикальный DMOS). Исследовательская группа Джона Молла из HP Labs изготовила прототипы DMOS в 1977 году и продемонстрировала преимущества перед VMOS, включая более низкое сопротивление в открытом состоянии и более высокое напряжение пробоя. В том же году Hitachi представила LDMOS (боковой DMOS), планарный тип DMOS. Hitachi был единственным производителем LDMOS в период с 1977 по 1983 год, когда LDMOS использовался в усилителях мощности звука таких производителей, как HH Electronics (серия V) и Ashly Audio , а также для музыки и систем громкой связи . С появлением в 1995 году цифровой мобильной сети 2G LDMOS стал наиболее широко используемым усилителем мощности RF в мобильных сетях, таких как 2G, 3G и 4G .
Алекс Лидоу вместе с Томом Херманом в Стэнфордском университете в 1977 году изобрел HexFET, гексагональный тип силового полевого МОП-транзистора . HexFET был коммерциализирован компанией International Rectifier в 1978 году. Биполярный транзистор с изолированным затвором (IGBT), который сочетает в себе элементы силового MOSFET и биполярного переходного транзистора (BJT), был разработан Джаянтом Балигой в General Electric в период с 1977 по 1979 год.
MOSFET с суперпереходом — это тип силового MOSFET, в котором используются столбцы P +, проникающие через N- эпитаксиальный слой. Идея наложения слоев P и N была впервые предложена Сёдзо Широта и Шигео Канеда в Осакском университете в 1978 году. Дэвид Дж. Коу из Philips изобрел полевой МОП-транзистор с чередованием слоев p-типа и n-типа, подав патент в США в 1984 году. который был награжден в 1988 году.






